
LG전자가 고대역폭메모리(HBM) 생산에 필요한 핵심 장비인 '하이브리드 본더(Hybrid Bonder)' 개발에 착수, 차세대 반도체 장비 시장 공략에 나섰다.
업계에 따르면, LG전자 생산기술원(PRI)은 최근 하이브리드 본더 개발 프로젝트를 공식화하고, 오는 2028년을 목표로 장비 상용화를 추진 중이다. 하이브리드 본더는 현재 HBM 생산에 쓰이는 'TC본더'의 업그레이드 버전이다.
LG전자의 이번 하이브리드 본더 개발 배경에는 인공지능(AI) 확산으로 HBM 수요가 빠르게 늘어나는 가운데, 그동안 축적한 반도체 패키징 기술력을 활용해 'B2B 신사업' 확대에 가속화한다는 전략으로 풀이된다.

HBM은 메모리를 수직으로 쌓아 올려 만든다. TC본더는 열(T, thermal)과 압력(C, compression)을 통해 칩과 기판을 연결하는데 사용되는 장비다.
반면, 하이브리드 본더는 TC본더의 '업그레이드' 모델이지만 칩과 기판을 연결하는 방법은 다르다. 칩과 기판에 있는 구리를 서로 자연스럽게 붙도록 하는 것이 핵심이다. 기존 열압착 방식(TC 본더)에 비해 온도가 너무 높지 않아도 되고 높은 압력이 필요하지도 않아 더 정밀하게 메모리와 기판을 붙일 수 있는 게 장점이다.
특히, 기존 방식에서 필요했던 연결 단자가 생략되면서 제조 효율이 향상되는 것이 특징이다.
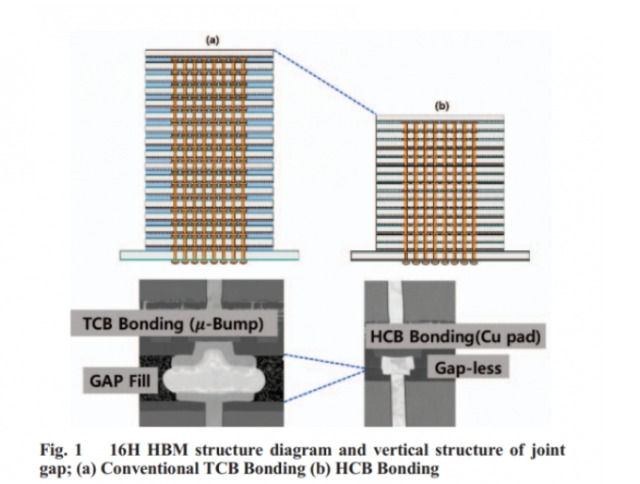
대신 그만큼 더 높은 기술 정밀도를 요구하기 때문에 현재 하이브리드 본더 연구는 활발하지만 본격적으로 생산하는 곳은 없는 상태다.
업계 관계자는 "HBM이 더욱 고성능을 내기 위해서는 더 얇고 많은 메모리가 적층돼야 하는데 현재 TC본더에서는 한계가 있다"며, "이를 극복할 수 있는 게 하이브리드 본더다"라고 설명했다.
LG전자의 진입으로 하이브리드 본더 시장 내 경쟁도 본격화할 전망이다. 현재 TC 본더 분야 점유율 1위인 한미반도체는 하이브리드 본더 개발에 속도를 내고 있으며 지난달에는 관련 전용 공장 건설에 285억 원을 투자했다. SK하이닉스와의 협업 경험을 바탕으로 차세대 HBM 장비 시장에서도 주도권을 유지하겠다는 계획이다.
또 삼성전자와 SK하이닉스가 각각 6세대 HBM(HBM4)과 7세대 제품(HBM4E)에 하이브리드 본더 장비 사용을 고려하고 있는 만큼, 필수 장비인 하이브리드 본더의 수요가 급증할 것으로 보인다. 미국 마이크론 테크놀로지 역시 하이브리드 본더 사용을 예고한 상황이다.
이외에도 한화세미텍, 도쿄일렉트론 등 글로벌 반도체 장비사들도 개발 경쟁에 뛰어들며 기술 선점을 노리고 있다.
시장조사업체 베리파이드마켓리서치에 따르면, 하이브리드 본딩 기술 시장 규모는 오는 2033년 140억2000만 달러(약 19조3,400억 원)까지 확대될 것으로 전망된다.
업계에서는 하이브리드 본더 기술 상용화가 아직 이뤄지지 않은 만큼 LG전자가 시장 선점 기회를 확보할지 주목하고 있다.
한편, LG전자는 이번 개발을 발판 삼아 반도체 패키징 관련 장비 포트폴리오를 다각화하고, 관련 사업 영역을 확대한다는 계획이다.